볼 그리드 어레이
본 서비스가 제공하는 내용 및 자료가 사실임을 보증하지 않습니다. 시스템은 언제나 실수를 할 수 있습니다. 중요한 의사결정 및 법리적 해석, 금전적 의사결정에 사용하지 마십시오.
볼 그리드 어레이(Ball Grid Array, BGA)는 집적회로(IC)를 인쇄 회로 기판(PCB)에 실장하기 위해 사용하는 표면 실장 패키징 방식이다. 기존의 핀 그리드 어레이(PGA)에서 파생되었으며, 패키지 바닥면에 핀 대신 작은 땜납볼(솔더볼)을 격자 모양으로 배열하여 전기적 신호를 전달한다. 패키지 주변부뿐만 아니라 바닥면 전체를 접점으로 활용할 수 있어 고밀도 연결이 가능하며, 마이크로프로세서와 메모리 등 고성능 반도체에 주로 사용된다.
개요 및 구조
볼 그리드 어레이는 집적회로의 한 면에 핀이 돋아 있는 핀 그리드 어레이(PGA) 기술에서 유래하였다. PGA의 핀은 부러지기 쉽고 핀 수가 많아질수록 패키지 크기가 커지는 단점이 있으나, BGA는 이를 패키지 바닥면에 부착된 땜납볼로 대체하여 문제를 해결한다. BGA는 수많은 논리 게이트나 회로를 포함하는 다층 구조로 구성될 수 있으며, 표준화된 다양한 모양과 크기로 제작된다.

실장 공정
BGA 소자의 실장은 자동화된 표면 실장 기술(SMT) 장비를 통해 이루어진다.
- 배치: 땜납볼과 동일한 패턴의 구리 패드가 있는 PCB 위에 BGA 소자를 배치한다. 이때 끈적한 플럭스를 사용하여 소자를 제자리에 고정한다.
- 가열: 리플로우 오븐이나 적외선 히터를 사용하여 열을 가한다.
- 접합: 열에 의해 땜납볼이 녹으면서 PCB의 패드와 결합한다. 이때 액체 상태인 땜납의 표면 장력에 의해 패키지가 PCB의 정확한 위치로 스스로 정렬되는 효과가 발생한다.
- 냉각: 땜납이 냉각되어 굳으면 전기적·기계적 접속이 완료된다.
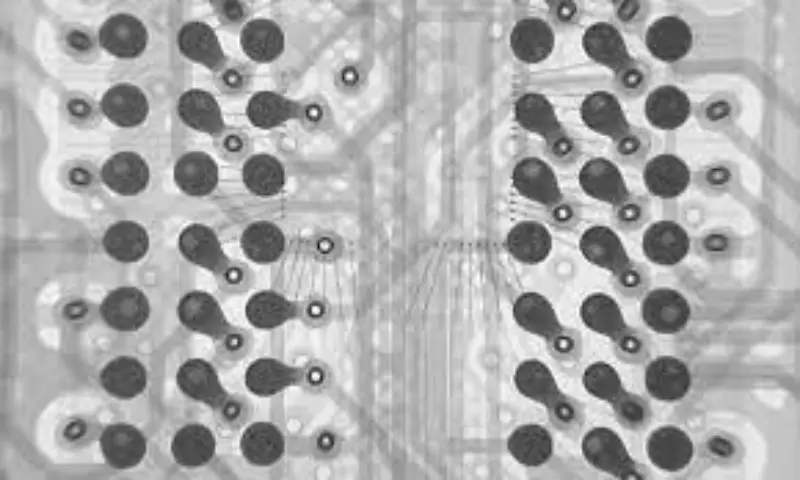
주요 장점
BGA는 기존 패키징 방식에 비해 다음과 같은 기술적 이점을 제공한다.
- 고밀도 연결: 패키지 바닥면 전체를 접점으로 사용하므로, 핀 간격이 좁아져도 단락 위험이 적고 한정된 면적에 더 많은 입출력 단자를 배치할 수 있다.
- 우수한 열전도: 패키지와 PCB 사이의 접촉 면적이 넓어 집적회로 내부에서 발생한 열을 기판으로 빠르게 방출할 수 있다. 이는 칩의 과열을 방지하는 데 효과적이다.
- 전기적 특성 향상: 접점 사이의 거리가 짧아 인덕턴스가 낮아지며, 이로 인해 고속 전자 회로에서 발생하는 신호 왜곡을 최소화할 수 있다.
특징 및 한계
BGA는 소켓을 사용하는 PGA나 LGA 방식과 달리 PCB에 완전히 납땜되는 구조이므로, 생산 이후에 칩을 교체하거나 수리하기가 어렵다. 또한 땜납볼의 배치가 정밀해야 하므로 컴퓨터로 제어되는 자동화 공정이 필수적이다. 주로 노트북, 스마트폰의 로직 보드에 탑재되는 시스템 온 칩(SoC)이나 고성능 마이크로프로세서의 영구 장착을 위해 사용된다.